applicazione del fotoresist e sviluppo
In questo run sono stati impressionati e sviluppati 3 substrati, con procedura identica a quella dell'esperimento del 16 settembre 2005, con l'unica differenza che la temperatura di softbake del LOL è stata portata a 176 °C. I tre substrati, chiamati nel seguito substrati B, C e D, sono stati sviluppati per tempi progressivamente più lunghi (200", 300" e 420", rispettivamente). Abbiamo quindi misurato il grado di undercut in funzione del tempo di sviluppo. Per il primo campione (200" di sviluppo) non è stato possibile osservare undercut. Per gli altri due si è misurato 1.0 µm e 1.8 µm, rispettivamente. Il risultato è mostrato nel seguente grafico.
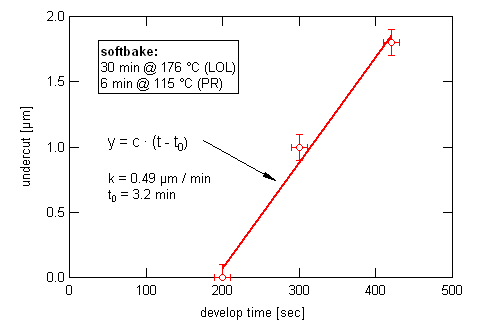
Dal best-fit con una retta si ottiene una velocità di rimozione laterale del LOL di 0.49 µm/min, rimozione che inizia 3.2 minuti dopo l'immersione nel developer. L'esperimento continua nel post successivo.
