Si conferma che la causa dell'eccessivo undercut è il tempo di soft-bake del LOL. Abbiamo ripetuto l'esperimento del 4-5 agosto 2005, aumentando il tempo di soft-bake del LOL (30 minuti a 160 °C) e del fotoresist (6 minuti a 115 °C). Il tempo di sviluppo (MF-321 a temperatura ambiente) è stato di 2' 10". I dettagli dell'esperimento saranno descritti nel post successivo. Il risultato dopo lo sviluppo è mostrato nell'immagine qui sotto (in contrasto DIC): l'undercut misura 3.2 ± 0.1 µm (prima era 11 ± 2 µm).

Le zone viola sono il substrato esposto, quelle rosa il bi-strato fotoresist+LOL, quelle bianche il solo fotoresist "a sbalzo" sul substrato. Il grado di undercut risulta tuttavia ancora eccessivo (0.5 - 1 µm dovrebbe essere sufficiente) e le strutture fini come i marker di allineamento non risultano riprodotti correttamente, come mostra la seguente immagine.
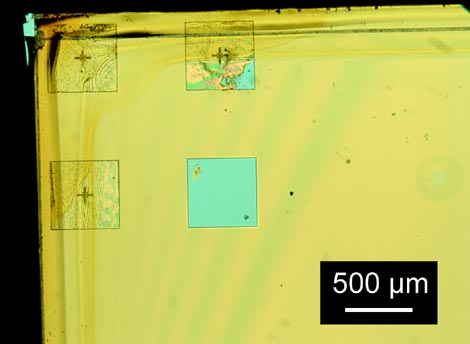
Si vede il fotoresist sviluppato in una zona di angolo del wafer, dove è presente un gradiente di spessore, evidenziato anche dalle frange d'interferenza. Il fotoresist è più spesso, nell'ordine: sull'angolo, sui bordi, al centro. Si nota che nella zona a spessore costante, ossia verso il centro del wafer, le strutture interne del marker (linee sottili che formano una croce) non vengono riprodotte, mentre sono visibili sul fotoresist più spesso. Le linee sottili, di spessore nominale 2 µm sono state "scavate alla base" dall'eccessivo undercut. È in corso un nuovo esperimento con una temperatura di soft-bake superiore (176 °C, che dovrebbe ulteriormente dimezzare la velocità di dissoluzione del LOL) e sviluppo progressivo a tappe di 30".
