Prima esposizione e sviluppo
- tagliati substrati SiO2 (600 nm) / Si (100) 20 x 20 mm
- scrub con acetone;
- lavati con acetone e IPA a 80 C e ultrasuoni;
- N2 blow dry;
- dispense 0.5 ml di resist ma-N 1420;
- spin @ 3000 rpm x 60 s (rampe 500 rpm/s);
- hotplate 100 C x 2 min;
- exposure 4.5 mW/cm2 @ 365 nm x 2.04 min (550 mJ/cm2);
- develop ma-D 533-S x 100 s
- DI rinse + N2 blow dry;
- spessore effettivo resist: 1.86 um.
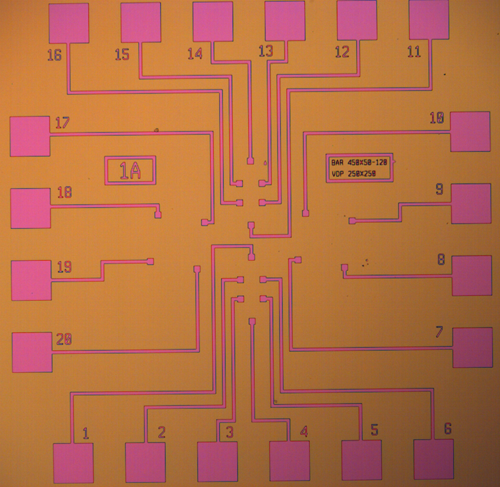
Metallizzazione e lift-off
- Evaporazione termica di 5 nm di Cr (corrente 30 A)
- Evaporazione termica 100 nm Au (corrente 130 A)
- NMP 80 C x 3 min + ultrasuoni
- NMP 80 C x 10 min
- NMP 80 C x 3 min + ultrasuoni
- DI rinse + N2 blow dry
- IPA + N2 blow dry
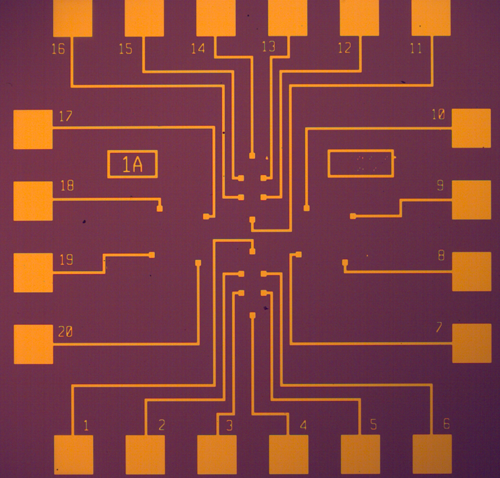
Seconda esposizione e sviluppo
- dispense 0.5 ml di resist ma-N 1420;
- spin @ 3000 rpm x 60 s (rampe 500 rpm/s);
- hotplate 100 C x 2 min;
- exposure 4.5 mW/cm2 @ 365 nm x 2.04 min (550 mJ/cm2);
- develop ma-D 533-S x 100 s
- DI rinse + N2 blow dry;


Deposizione del materiale e lift-off
- Deposizione 100 nm AZO 4% (campione #69, 5 mTorr, ZnO 120 W RF, Al 0.14 A, 260 V DC, rate 1.0 Å/s, process #13, film #3, 1875 Å nom);
- Deposizione 100 nm SiO2 (90 W RF, rate 0.33 Å/s, process # 25, film # 25, 1825 Å nom).
- misura profilometro: AZO 223 nm, Au wires 96.5 nm;
- soak in NMP 80 °C x 10 min + 10 min ultrasuoni, rinse IPA, N2 blow dry.