Dopo aver testato il funzionamento del Cu come layer a perdere, riprendiamo la realizzazione della superlente.
Realizzazione di 4 campioni di Cu/Cr/MgO(001) (01/03/10)
Crescita di multilayer Cu(50 nm)/Cr(35 nm)/MgO(001). Cu e Cr sono stati depositati via sputtering utilizzando le recenti calibrazioni. Sono stati preparati 4 campioni su 4 lastrine di MgO contemporaneamente. Le lastrine sono poi state divise in 4 parti ciascuna, ottenendo un numero maggiore di campioni.
Lavorazione multilayer 1
(FIB:03/03/10; MgO dep:15/03/10; etching e AFM:17/03/10)
È stato realizzato il pattern FIB sul campione 1 della serie preparata il 01/03/10. Quindi è stato depositato il film di MgO via MBE reattivo dopo sputtering del substrato per riempire il pattern. Per un errore nel calcolo del tempo di deposizione, lo spessore del film è di 50 nm invece che di 35 nm. Il multistrato è stato quindi immerso in persolfato d'ammonio 20% wt/wt per i tempi indicati in figura.
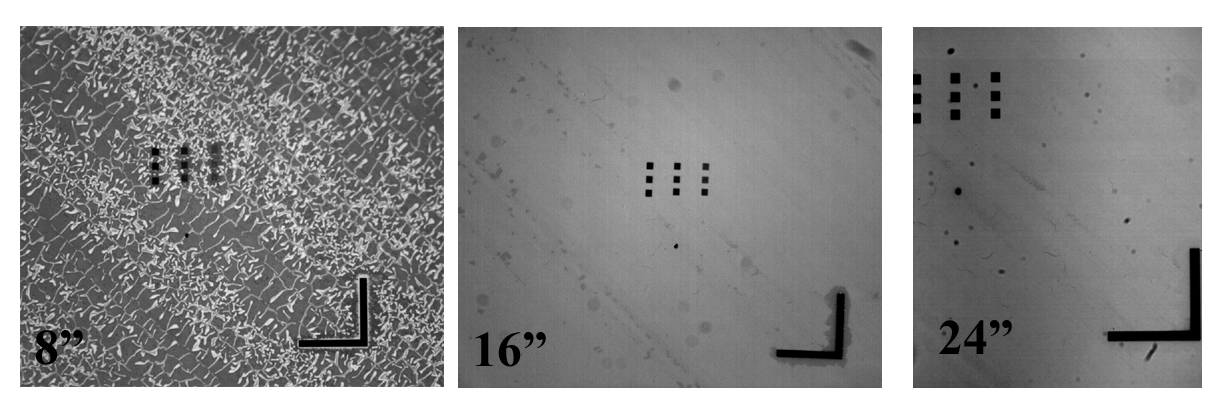
Sono stati necessari 24" per rimuovere tutto il Cu dalla superficie del multilayer. Dopo 16" di etching sono state fatte immagini SEM e AFM dei pattern, che mostrano come ci siano ancora parti di film non rimosso nel pattern più piccolo (largh. 90 nm). I profili delle immagini AFM confermano lo spessore di MgO depositato (circa 10-15 nm in più del necessario per riempire i pattern) e la non totale rimozione del Cu. L'AFM indica che la rimozione del materiale all'interno del pattern da 90 nm è aumentata e il pattern risulta più pulito. Ci sono ancora resti però di materiale (Cu o sporco?).
Lavorazione multilayer 2
(FIB: 24/03/10; MgO dep:25/03/10; etching:13/04/10)
Patternato al FIB il campione 2 della serie preparata il 01/03/10 e cresciuto MgO(35 nm) come da condizioni 12/10/2009 (vedi sotto). Etching in persolfato di ammonio 20% wt/wt per 24" + 8" per rimuovere tutto il Cu visibile all'ottico intorno al pattern. L'AFM indica che l'etching ha funzionato, anche se c'è ancora materiale (in forma di cluster) non rimosso nei pattern. Il rimepimento degli scavi risulta di nuovo troppo elevato (gli scavi sono circa 5-7 nm più alti delle parti non scavate).
Lavorazione multilayer 3
(FIB: 24/03/10; MgO dep:03/05/10; etching:03/06/10)
Patternato al FIB il campione 3 della serie preparata il 01/03/10 e cresciuto MgO(35 nm) come da condizioni 12/10/2009 (vedi sotto) per 50' 51", in considerazione del troppo alto spessore di MgO del campione precedente (camp 2).
Etching in persolfato di ammonio 20% wt/wt per 8" con soluzione a 37 °C (set temperatura vasca a 45 °C) in ultrasuoni. In un primo momento il campione è stato introdotto sul fondo di una retina di acciaio. Siccome però il campione rimane a galla, è stata tolta la retina e il campione è stato immerso sostenuto da pinzette come in passato. All'ottico il campione è pulito. Al SEM il campione non mostra tracce residue del film di MgO/Cu, ma risulta corroso anche il MgO depositato all'interno deglli scavi, mentre nei casi precedenti di attacco non se ne osservava la rimozione. Un ulteriore attacco di 8" (stavolta col campione sostenuto solo da pinzette) hanno rimosso completamente l'MgO all'interno degli scavi.

Prove di etching in persolfato di ammonio a 37 °C
La soluzione di (NH4)2S2O8 20% w/w ha pH 2.44 a 18 °C appena preparata. Scaldando la soluzione a 40 °C, il pH scende a 2.38. Etching di un campione Cu(35 nm)/Cr(35 nm)/MgO(001): in 4 s viene rimosso tutto il Cu (check all'ottico). Dopo 3 h il pH della soluzione mantenuta a caldo è sceso a 1.78. Etching di lastrina di MgO(001): Deposizione di una goccia di photoresist S1813; etching in (NH4)2S2O8 20% wt/wt per 10 min.; rimozione photoresist con remover 1165; misura con profilometro attraverso il bordo della goccia. L'erosione del MgO risulta essere di 1.2 um in 10 min (2 nm/s).
Lavorazione multilayer 5
(FIB: 06/06/10; MgO dep:10/06/10; etching:10/06/10)
Patternato al FIB il campione 5 della serie preparata il 01/03/10 e cresciuto MgO(35 nm) come da condizioni 12/10/2009 (vedi sotto) per 51', in considerazione del troppo alto spessore di MgO del campione precedente (camp 2).
TEST ETCHING al SEM:
Per attacco chimico: T(ambiente)= 22 °C , T(acqua)=23 °C (misura con termometro grande macchiato)
T(soluzione)=15 °C appena preparata ((NH4)2S2O8 20% w/w), lascio termalizzare a temperatura ambiente.
Dopo 1h la soluzione è a 24 °C. Attacco 8" e controllo all'ottico. E' rimasto Cu intorno alle zone scavate al FIB.
Attacco ancora 8" e ricontrollo all'ottico. Il Cu è stato rimosso cosi come parte del film di Cr. Al centro è rimasta solo la zona patternata. Al SEM il pattern mostra ancora resti di film tra gli scavi (servirebbe tempo di attacco più lungo). Data la bassa adesione del Cr, decidiamo di non attaccare ulteriormente, ma di guardare con l'AFM il riempimento dei pattern.
La ragione del distaccamento del film di Cr potrebbe essere l'invecchiamento del campione.
Campioni 4 e 6 patternati, sul fondo del fast entry. Campione 4 ha problemi al SEM.
Problemi e possibili soluzioni:
- Ripetere l'etching a temperatura ambiente, monitorando la temperatura della soluzione e usando campioni possibilmente recenti.
- Controllare il riempimento degli scavi con una cross section FIB-SEM (oltre che con l'AFM).
- Studiare la possibilità di crescere tutti i film (Cr, MgO) dopo aver scaldato i substrati per migliorare l'adesione e la morfologia.
- Deposizione della lente di Ag: morfologia e rugosità del film ottenuto sul multilayer.
- Ottenere un photoresist di spessore 100 nm. Da comprare il solvente per diluire photoresist.
- Lampada per impressionamento del photoresist: filtri, altro? per ottenere luce monocromatica o variabile.
