Lo scopo di questa procedura è la realizzazione di reeds di silicio, ossia lamelle di dimensione 26 x 4 mm e spessore 50-70 µm, che vengono usati come oscillatori meccanici. Per il montaggio e la manipolazione, i reeds devono avere una porzione di circa 10 mm della loro lunghezza avente lo spessore nominale del wafer, ossia 275 µm. Per questa fabbricazione sarà utilizzata la tecnica di etching anisotropo del Si per mezzo di una soluzione di KOH al 30% wt/wt a 80 °C.

breve descrizione della procedura
Il materiale di partenza è un wafer di Si(100) intrinseco, fornito dalla Siltronix, diametro 2", spessore nominale 275 µm. I wafer sono lappati ed ossidati su ambo i lati con ossido termico per uno spessore di 1.5 µm. Il wafer viene tagliato con lo scriber in rettangoli aventi le dimensioni laterali nominali dei reeds: 26 x 4 mm. Si mascherano ambo i lati dei reeds per proteggere 10 mm di lunghezza, utilizzando il nastro blu (blue dicing tape, medium tack). Si dissolve l'ossido termico sulle zone scoperte utilizzando una soluzione BOE (40207 della Sigma Aldrich). Si elimina la mascheratura e si procede con il deep etching in KOH 30% wt/wt a 80 °C. Si controlla l'andamento del processo di etching misurando periodicamente lo spessore residuo per mezzo del tastatore elettronico del CIGS. Si interrompe il processo di etching al raggiungimento dello spessore desiderato.
descrizione dettagliata
1 - Si determina preliminarmente la velocità di erosione della soluzione BOE sull'ossido termico, che sarà utilizzata alla temperatura ambiente di 22 ± 1 °C. Ciò permetterà di erodere gli 1.5 µm di ossido termico senza eccessivo overetch che potrebbe danneggiare la superficie del Si sottostante. L'esperimento consiste del misurare lo spessore di ossido termico residuo prima e dopo un bagno in BOE della durata di 3 min. Il materiale di partenza è un frammento dello stesso wafer che sarà utilizzato per fabbricare il reeds. Lo spessore di ossido sarà determinato attraverso la misura della riflettività a incidenza quasi normale nel campo di lunghezze d'onda 400 ÷ 1100 nm e confronto con i risultati di una simulazione che tiene conto dell'interferenza dei film sottili (software TFCalc). Il campione, lavato in acetone subito dopo il taglio del wafer nuovo, viene fissato ad un supporto in polistirolo (navicella per pesata modificata) e successivamente lavato in acqua UPW.
Campione e supporto vengono immersi per il tempo desiderato (3 min) nella soluzione BOE contenuta in un becker in PTFE ed agitazione magnetica a 150 rpm.
La riflettività del materiale misurata prima e dopo l'etching è mostrata nella seguente figura. Le simulazioni mostrano che in 3 minuti di etching a temperatura ambiente (22 ± 1 °C) lo spessore di ossido termico passa da 1546 ± 2 nm a 1240 ± 2 nm quindi in queste condizioni la velocità di erosione è di 102 ± 1 nm/min. Per la simulazione sono stati usati i files SIO2.MAT e SIPOLY.MAT del database Sopra SA. Per eliminare completamente l'ossido (spessore nominale 1500 nm ± 10%), tenendo conto di un margine di overetch del 20% si ottiene un tempo di etching di 20 min.
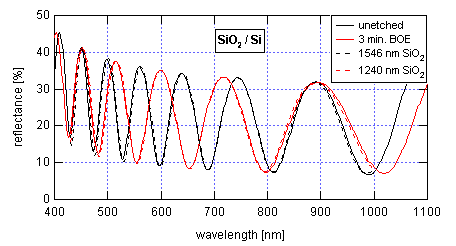
2 - Si mascherano i reeds per definire geometricamente la parte per il montaggio e la manipolazione. Per il mascheramento si utilizza lo standard dicing tape, blue, medium tack, seguendo le operazioni illustrate qui sotto.
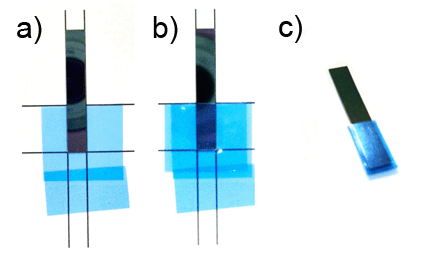
3 - etching dell'ossido termico con soluzione BOE. Si immergono per 20 min i reeds mascherati in soluzione BOE a temperatura ambiente e agitazione magnetica, 150 rpm, becker in PTFE. Per la manipolazione dei reeds in soluzione si utilizza uno speciale supporto in polistirolo, come quello mostrato qui sotto.
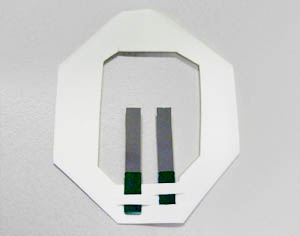
Completata la procedura di etching i reeds, ancora montati sul supporto, vengono lavati in acqua ultrapura. Successivamente si rimuove la maschera ed i campioni vengono nuovamente lavati in acetone e rimontati sul supporto per l'etching successivo.
4 - Deep etching del Si in soluzione KOH. In un becker di PTFE si prepara una soluzione di KOH 30% wt/wt sciogliendo 60 g di KOH in 140 g di H2O. Si annota anche il peso complessivo della soluzione+becker+stirrer che servirà come valore di riferimento per le successive, periodiche aggiunte di acqua per compensare le perdite per evaporazione. Si immerge il becker in un bagnomaria a 80 °C, che si ottiene per un setpoint della temperatura della piastra di 240 °C. Il becker è tenuto sollevato dal fondo del bagnomaria da un supporto che consente la collocazione di uno stirrer per l'acqua. Un altro stirrer è collocato nel becker contenente la soluzione. Un'altra hotplate si servizio è utilizzata per mantenere a 80 °C un becker contenente 1000 ml di acqua ultrapura, utilizzata per compensare le perdite per evaporazione sia del bagnomaria che della soluzione KOH. La frequenza delle operazioni di manutenzione della soluzione è di circa 45 - 60 minuti. Un'immagine del setup utilizzato è mostrata qui sotto.
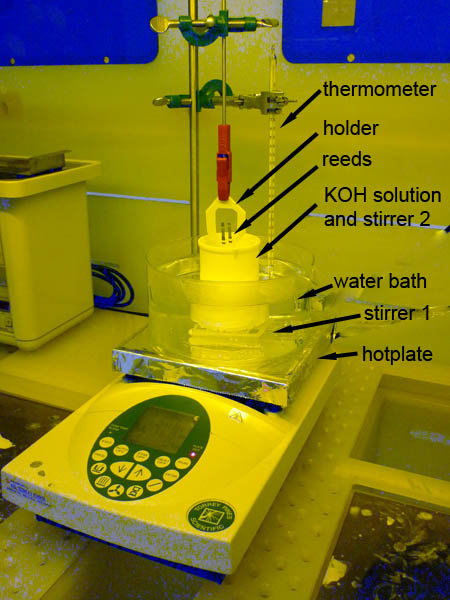
La velocità di erosione è di circa 50 µm/h su ogni lato (la diminuzione di spessore complessivo del reed è quindi di circa 100 µm/h). Si esegue una sessione di etching della durata di un'ora, poi si procede a misurare la profondità di etching con il profilometro e/o con il tastatore del CIGS.

Si esegue la manutenzione della soluzione, aggiungendo la quantità di H2O che ne ripristini il peso iniziale. Si esegue una seconda sessione di etching della durata di 45 minuti e si misura la differenza di spessore del reed rispetto al valore di target (50 ÷ 70 µm). Si esegue la manutenzione della soluzione e di esegue l'ultimo etching per una durata calcolata sulla base della differenza di spessore residua e sulla velocità di erosione calcolata sulle precedenti sessioni.
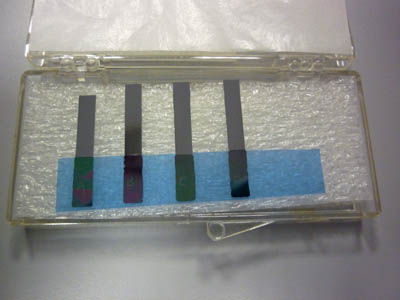
I reeds così fabbricati sono pronti per l'uso, il confezionamento o lo stoccaggio.
