Dopo lo sviluppo, i substrati sono stati spezzati in più parti. Alcune parti sono state metallizzate con Au/Cr presso il laboratorio bio-lab, altre sono state analizzate al microscopio ottico per stimare la qualità delle strutture litografate nel fotoresist e verificare l'esistenza dell'undercut. I substrati provenienti dai due run del 4 e 5 agosto si sono rivelati molto simili, che indica che le differenze nelle procedure di preparazione si sono manifestate in fasi non eccessivamente critiche.
Seguono immagini a basso ingrandimento del fotoresist sviluppato.
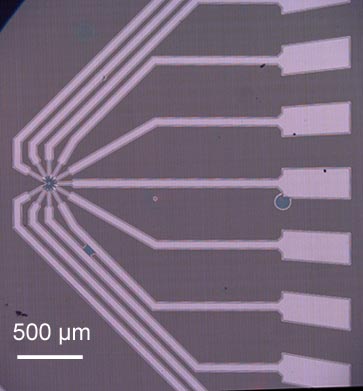

Le zone chiare indicano le aperture nel fotoresist (substrato esposto), mentre le aree marroni rappresentano il fotoresist non esposto. Le immagini mostrano probabilmente la presenza di undercut (doppia linea che contorna le strutture litografiche, più evidente nella seconda immagine). La qualità delle strutture è soddisfacente (linee continue, assenza di frastagliature). Si osserva la presenza di particelle estranee (polvere? specialmente nella seconda immagine).
Le immagini a più alto ingrandimento che seguono indicano che il grado di undercut (compreso fra i 9 e i 13 µm) risulta eccessivo, tanto che le strutture più piccole della maschera (crocini di allineamento, non mostrate qui) non risultano riprodotte dal fotoresist, essendo state completamente asportate dall'eccessivo effetto undercut. I crocini di allineamento, contrariamente alle aperture, dovrebbero risultare come sottili linee (2 µm, nominalmente) di fotoresist non esposto circondate da grandi aperture. Queste strutture sono particolarmente fragili dal punto di vista dell'effetto undercut, perché possono essere erose alla base ed asportate completamente in fase di sviluppo. Il grado eccessivo di undercut può essere dovuto a i) tempo/temperatura di sviluppo eccessivi; ii) tempo/temperatura di softbake del LOL insufficienti.
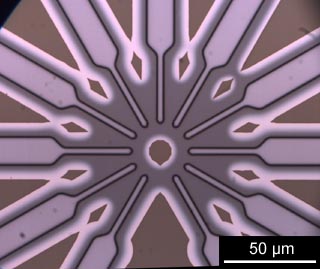
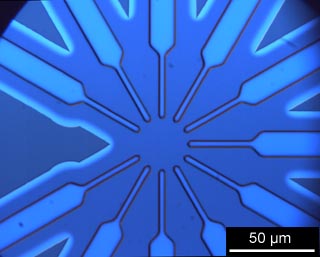
Le strutture litografiche incise vengono qui di seguito confrontate con le dimensioni nominali della maschera (riga verde sottile). Si osserva che le aperture nel fotoresist sono più piccole (di circa 1.8 µm, larghezza totale delle aperture) e più arrotondate di quelle nominali nella maschera. Tuttavia, per avere un'informazione più completa, occorrerebbe confrontare l'immagine del fotoresist con quella della maschera reale, non con le sue dimensioni nominali.
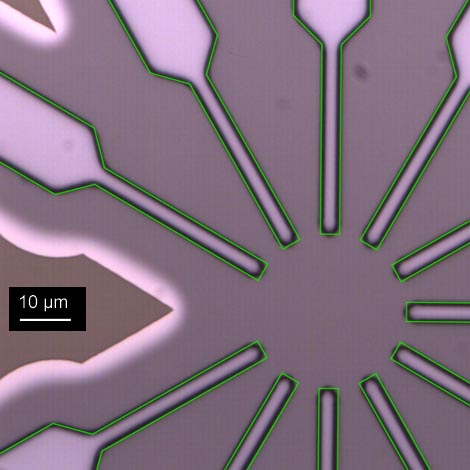
A parte l'eccessivo grado di undercut e la ridotta dimensione delle aperture nel fotoresist, questi primi risultati sono soddisfacenti perché tutte le strutture litografiche della maschera sono state riprodotte sul fotoresist (con l'esclusione dei crocini di allineamento che, dato l'eccessivo grado di undercut, non potevano essere riprodotti).
